Термическое ALD
В большинстве реакций ALD в качестве прекурсоров используется два или более компонента. Они реагируют с материалом на поверхности подложки в непрерывном и самоограничивающимся процессе.
Атомно-слоевое осаждение
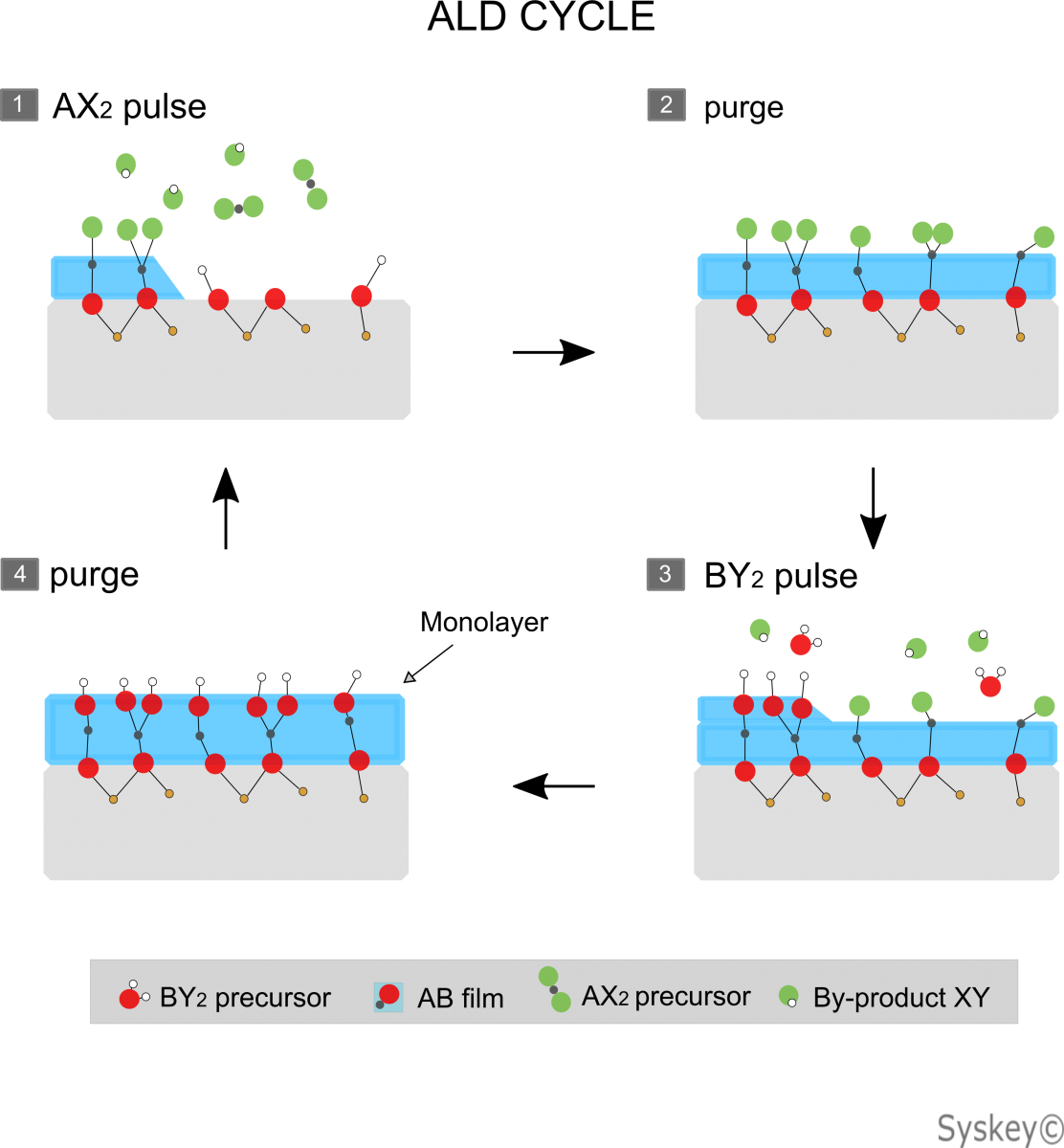
ALD Атомно-слоевое осаждение – одна из самых важных технологий нанесения тонких плёнок, основанная на последовательном переключении различных процессов химического осаждения из газовой фазы. Атомно-слоевое осаждение часто рассматривается как особый тип химического осаждения из газовой фазы (CVD). Большинство химических реакций в процессах ALD используют два или более химических соединений, называемых прекурсорами. Прекурсоры последовательно реагируют с поверхностью материала в самоограничивающемся процессе, который отличается низкой скоростью осаждения пленок и высочайшей равномерностью. Циклы обработки прекурсорами чередуются с циклами продувки что исключает прямое взаимодействие прекурсоров в рабочей камере между собой до осаждения на пластину. ALD является важным процессом в производстве полупроводниковых приборов и необходимым элементом инструментария для синтеза наноматериалов, позволяет получать слои толщиной менее 1 нанометра.
ALD обладает рядом преимуществ, таких как отличная однородность, высочайшая конформность пленки, нанесенной на сложные структуры с высокой топологией, низкая температура процесса. ALD применяется во многих областях микроэлектроники, нанотехнологий и биотехнологий, где часто работают на гибких подложках, в том числе на органических и биологических материалах.
Однородность по толщине:
Для нанесения пленок Al2O3 и HfO2 с целевой толщиной в 5 нм были использованы пластины диаметром 12 дюйм (300 мм). С помощью эллипсометра были проведены измерения в 27 точках и применена формула стандартного распределения. Результат оказался в пределах ± 0,5 нм и 5% неоднородности.
| Al2O3 Однородность=1.58% |
HlfO2 Однородность=1.27% |
.png) |
.png) |
Диэлектрическая постоянная и работа выхода:
На трех подготовленных кремниевых пластинах было произведено осаждение структур Al2O3 / TiN и химоксид / HfO2 / TiN с заданными толщинами. Результаты расчета диэлектрической постоянной и тока утечки на основании полученных измерений диаграмм напряжения и тока трех образцов: диэлектрическая константа находится в пределах 7 ~ 9 (Al2O3) и 18 ~ 22 (HfO2), ток утечки не превышает 1 нA (при 1В).