+886-3-5590169
+886-3-5574282
info@syskey.com.tw
Термическое ALD


Установка атомно-слоевого осаждения представляет собой метод парофазного химического осаждения. Это один из способов химического осаждения из газовой фазы. В большинстве реакций ALD в качестве прекурсоров используются два химических вещества. Эти прекурсоры взаимодействуют с поверхностью материала непрерывным и самоограничивающимся образом. За счёт повторяемого взаимодействия с прекурсором медленно осаждается тонкая пленка. Для термического атомно-слоевого осаждения требуются относительно высокие температуры (обычно 150-350 °С).
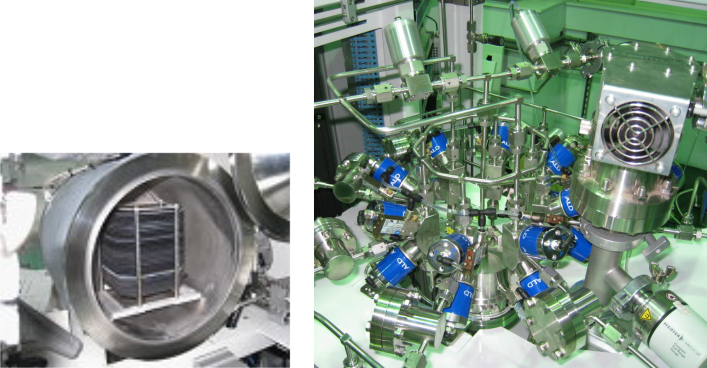
Установка от компании Syskey может контролировать процесс ALD,толщину пленки, а однородность составляет менее ±1%.

Однородность по толщине (WIW):
Для нанесения пленок Al2O3 и HfO2 с целевой толщиной в 5 нм были использованы пластины диаметром 12 дюйм (300 мм). С помощью эллипсометра были проведены измерения в 27 точках и применена формула стандартного распределения. Результат оказался в пределах ± 0,5 нм и 5% неоднородности.
| Al2O3 Однородность=1.58% |
HlfO2 Однородность=1.27% |
.png) |
.png) |
Диэлектрическая постоянная и работа выхода:
На трех подготовленных кремниевых пластинах было произведено осаждение структур Al2O3 / TiN и химоксид / HfO2 / TiN с заданными толщинами. Результаты расчета диэлектрической постоянной и тока утечки на основании полученных измерений диаграмм напряжения и тока трех образцов: диэлектрическая константа находится в пределах 7 ~ 9 (Al2O3) и 18 ~ 22 (HfO2), ток утечки не превышает 1 нA (при 1В).
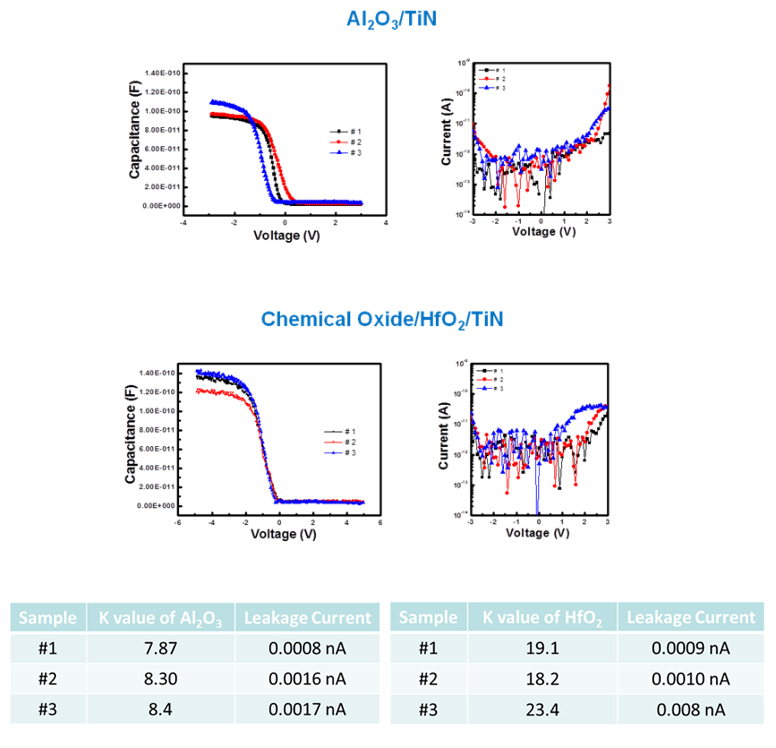
| Область применения | Вакуумная камера |
|
|
| Конфигурации и преимущества | Опции |
|
|